作者:孙千 本文转载自公众号:老千和他的朋友们。原文地址:https://mp.weixin.qq.com/s/XjXvdX4shTWGwNxPaliZbw
在扫描电镜(SEM)、聚焦离子束(FIB)及 FIB-SEM系统的日常使用中,碳污染一直是个让人头疼的问题,严重制约着实验结果的准确性和样品制备质量。
这类污染的源头很明确:真空室中残留的烃类分子会吸附在样品表面,一旦被电子束或离子束照射,就会分解成无定形碳等污染物 —— 这些污染物以 sp²、sp³ 两种化学键形式附着,不仅会让成像出现虚假痕迹、导致关键尺寸测量不准,还会影响透射电镜(TEM)薄片的纯度、纳米器件的导电性能等核心指标。
但传统的碳污染监测方法都有明显缺陷:残留气体分析只能找出污染源,却没法跟踪局部污染的变化;而 nanoflight® 技术需要复杂的多探测器系统,目前还未完全成熟。因此,科研人员一直迫切需要一种既能灵敏捕捉表面污染、又能实现高分辨率观测,还不会损伤样品、适配常规设备的原位监测技术。
针对这一需求,Nicholas T. H. Farr 等人开展了系统性研究,不仅验证了二次电子能谱(SES)与二次电子高光谱成像(SEHI)的监测效果,还找到了无需化学处理就能去除碳污染的方法,为 FIB-SEM 技术的优化应用提供了重要支撑。

实验设计:样品、仪器与数据处理
核心实验样品
研究选取了两类关键样品搭建实验体系,一类是高定向热解石墨(HOPG),分为新鲜样品和老化样品,新鲜样品在机械剥离后 1 分钟内快速装样,避免被大气污染,老化样品则长期暴露在空气中,自然积累了污染和氧化层,用于精准分析碳化学键的变化规律;另一类是 Ti6246 合金(含 6% Al、2% Sn、4% Zr、6% Mo,其余为 Ti),经 1200 目打磨后未做任何导电涂层,专门用于验证碳污染的去除效果。
仪器与实验参数
实验使用了两款不同型号的 FIB-SEM 系统(Helios G4-CXe PFIB 与 Helios Nanolab G3 UC),为保证数据可比性,核心实验参数保持一致,具体为加速电压 1kV(单色化模式)、束电流 50pA(浸没模式)、真空度约 10⁻⁶ mbar、工作距离 4mm,这样的参数设置既能减少样品损伤,又能保证信号稳定,其中氙等离子体 FIB(Xe⁺ PFIB)的处理参数明确为照射 10×10μm 区域、离子束电流 1nA、单次照射 20s、剂量 0.2nC/μm²。
数据处理方法
数据处理过程中,通过调整镜电极电压(范围– 15V~15V,对应电子能量 – 0.7eV~12.7eV,步长 0.2eV)来收集不同能量范围的二次电子信号,先使用 Fiji Image J 软件进行预处理,再借助非负矩阵分解(NNMF)这一常用数据分析方法,将复杂的图像信号拆分为 6 个特征组分,从 SEHI 图像堆栈中提取出特征光谱,最终实现碳污染及化学键状态的纳米级化学成像。
二次电子能谱(SES)与二次电子高光谱成像(SEHI)均依托配备透射透镜探测器(TLD)的现有 FIB-SEM,在 1kV 低加速电压、~10⁻⁶ mbar 真空度(SEHI 额外不施加样品导电涂层)的低损伤/稳定条件下,通过 iFast 自动程序将镜像电极电压(MV)在 – 15V~+15V 区间分步扫描(对应 0.2eV 能量步长)。
其中 SES 采集二次电子计数形成 S 曲线,经 Fiji Image J 软件一阶求导、校准后,通过能谱峰位(如 sp² 碳 2~4.2eV、sp³ 碳 4.6~6eV)与强度实现化学状态识别及含量量化,SEHI 则进一步采集不同能量二次电子空间分布形成图像栈,结合 SES 提取与非负矩阵分解(NNMF)组分分离,生成纳米尺度化学成像图与能谱,完成碳污染空间定位与化学状态分析,全程无需额外仪器改造。通俗的讲,可以把SES类比为EDS中的点模式,SEHI是面扫描模式。Monitoring Carbon in Electron and Ion Beam Deposition within FIB-SEM
实验结果:碳污染监测与去除的关键发现
碳污染的 “光谱基准” 确立
以 HOPG 样品为研究对象的测试结果十分明确,从图 1 的多组能谱对比中可直观观察到,图 1 包含四组数据,分别是 Helios PFIB 中采集的 EBID HOPG、普通 HOPG 及老化 HOPG 的二次电子能谱,同一仪器下以 5.2eV sp³ 杂化键合峰归一化后的能谱,Helios Ga- FIB 中采集的同款样品能谱,以及对应的归一化结果,两款 FIB-SEM 系统均能稳定检测到两个特征光谱峰,2–4.2eV 区间对应 sp² 杂化碳(包括无定形碳),4.6–6eV 区间对应 sp³ 杂化碳,这与前人研究结论一致,相当于确立了碳污染监测的 “光谱基准”。

图1 (A)在PFIB中采集的EBID高定向热解石墨(HOPG)、普通 HOPG 及老化 HOPG 的二次电子能谱(SES);(B)在PFIB 中采集的 EBID HOPG、普通 HOPG 及老化 HOPG 的 SES(以 5.2 eV sp³ 杂化键合峰为基准归一化);(C)Ga FIB 中采集的 EBID HOPG、普通 HOPG 及老化 HOPG 的 SES;(D)Ga FIB 中采集的 EBID HOPG、普通 HOPG 及老化 HOPG 的 SES(以 5.2 eV sp³ 杂化键合峰为基准归一化)。
电子束加速碳污染沉积的直接证据
电子束诱导沉积(EBID)实验的测试结果与图 2分析高度契合,图 2(A)为 Helios PFIB 中采集的三类 HOPG 样品二次电子能谱,(B)为能谱采集区域的二次电子图像,清晰标注了测试位置,通过化学成像技术还得到了 sp²/CHₓ键合、sp³ 杂化键合、CO/OH 键合的二次电子化学成像图,其中(F)为 CO/OH 键合的对比度增强版成像图,便于更清晰地观察氧化分布,结果显示电子束扫描 60s 形成的 EBID 窗口内,无定形碳的积累量明显多于老化 HOPG 和新鲜 HOPG,直观证明了电子束照射会加速碳污染沉积。

图 2 (A)P FIB 中采集的 EBID HOPG、普通 HOPG 及老化 HOPG 的SES;(B)SES 采集区域对应的 SE 图像;(C)sp²/CHₓ键合二次电子化学成像图;(D)sp³ 杂化键合二次电子化学成像图;(E)CO/OH 键合二次电子化学成像图;(F)CO/OH 键合对比度增强型二次电子化学成像图。
碳化学键的动态变化规律
图 3 完整呈现了时间序列监测的细节,(A)为新鲜 EBID 与照射 60 秒后 EBID 的二次电子能谱对比,(B)(C)分别为同一区域照射前后的二次电子图像(不同视场),谱图对比明确显示碳化学键的动态变化,新鲜 EBID 区域的 sp³ 键信号强度显著高于 60s 后,呈现 “先形成后减弱” 的规律。
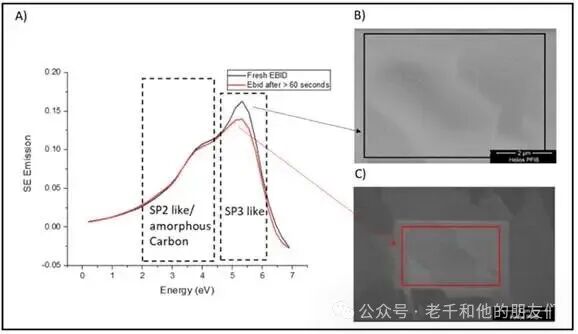
图 3(A)PFIB 中采集的新鲜 EBID 与照射 60 s 后 EBID 的SES对比;(B)新鲜 EBID 的 SES 采集区域 SE 图像(10 µm HFW);(C)图(B)同一区域照射 60 s 后的 SE 图像(20 µm HFW),用于后续 SES 采集。
这一现象的核心原理并不复杂,一开始电子束会让真空室残留的烃类分子在石墨表面缺陷处分解,氢原子与石墨表面结合,使原本的 sp² 化学键转变成 sp³,之后 sp³ 键改变了样品表面的能量状态,会吸引更多烃类分子吸附分解,无定形碳(sp²)不断积累,逐渐掩盖了 sp³ 键的信号。
同时,图 2 的化学成像还揭示了氧化分布特点,HOPG 的氧化产物(CO/OH)主要集中在未完全剥离的老化晶粒区域,而 EBID 污染层能部分覆盖这些氧化层,这一发现提醒我们,碳污染不仅会影响成像质量,还可能干扰对样品表面化学状态的准确判断。
PFIB 的碳污染去除效果
Ti6246 合金表面碳污染的测试结果集中体现在图 4 中,(A)为合金及 FIB 照射后样品的二次电子能谱与对应采集区域图像,(B)为不同时间点的能谱与图像对比。

图 4 (A)PFIB 中采集的 Ti6246 钛合金(Ti)及 FIB 照射后 Ti 合金的 SES及对应采集区域 SE 图像;(B)P FIB 中采集的 Ti6246 钛合金(Ti)及 FIB 照射后不同时间点 Ti 合金的 SES 及对应采集区域 SE 图像。
关键发现包括,Xe⁺ PFIB 处理后,2–4.3eV 区间的无定形碳特征峰明显减弱,说明无需化学处理,该方法就能高效去除碳污染,对于怕化学处理的样品来说,这是更稳妥的污染控制方案,但处理后30分钟、60分钟,碳污染会逐渐回升,因此实际应用中需结合 SEHI/SES 技术实时监测,精准找到最佳实验窗口期,避免污染回升影响结果.
同时处理后样品的 SES 谱图在 5.4–6.1eV 区间出现新特征峰,结合文献推测为 Ti 氧化物信号,说明Xe⁺ PFIB 处理虽能除碳,但会增强 Ti 表面化学活性,引发轻微氧化,未来需根据实验需求调整操作环境,在污染去除效果与样品表面稳定性之间找到平衡。
研究的应用价值
研究通过系统实验和原理分析,取得了三项突破。首先是证实了 SES 与 SEHI 技术的实用性,它们既能灵敏捕捉表面污染,又能实现高分辨率观测,且不会因电子束能过高损伤样品,可在不同型号 FIB-SEM 系统中稳定监测碳污染的积累、去除及 sp²/sp³ 化学键变化,无需额外改装仪器,只要是带 Through-the-Lens Detectors(TLD)的常规 FIB-SEM 都能使用,通用性和操作便捷性极强。
其次是找到了Xe⁺P FIB 这一 “绿色方案”,无需化学处理即可去除碳污染,能有效提升纳米器件的制备纯度(如改善纳米导体导电性)和成像准确性,特别适合对化学处理敏感的样品。
最后是拓展了化学成像的应用场景,SEHI 结合NNMF分析的化学成像能力,成功实现了有机、无机材料表面的纳米级化学状态表征,为 FIB-SEM 技术开辟了更多应用可能。
未来研究可聚焦两个方向,一是深入探究无机氧化物的二次电子特征峰规律,提升SEHI 技术的定量分析精度;二是针对碳污染回升问题,开发更高效的 “清洁–监测” 一体化方案,结合智能算法实现污染的动态预警和精准调控,推动 FIB-SEM 技术向更精准、稳定可靠的方向发展。
参考资料Monitoring Carbon in Electron and Ion Beam Deposition within FIB-SEM


