作者:孙千 本文转载自公众号:老千和他的朋友们。原文地址:https://mp.weixin.qq.com/s/6ouN6rpV5QlFLBb1EK9vlg
在透射电镜(TEM)的X射线分析领域,研究人员始终致力于获取接近空间分辨率极限的物质信息,而这一目标的实现离不开对各项控制因素的深入理解。空间分辨率与最小检测限作为分析过程中的核心指标,二者存在紧密且复杂的关联,同时TEM样品厚度的精准测量也对分析结果的可靠性起着关键作用。
随着TEM – EDS系统相关技术的不断进步,尤其是球差(Cs)校正技术的应用,如今在同一台仪器中实现原子柱分辨率的 X 射线分析和单原子检测已成为现实。
空间分辨率:定义、意义与优化
空间分辨率的重要性
TEM中X射线分析之所以能得到广泛应用,核心驱动力在于其相较于电子探针(EPMA)在空间分辨率上的显著提升。这一优势的形成源于两个关键因素:一是采用薄样品,减少了电子穿过样品时的散射;二是 TEM 中电子能量更高(通常在 100 – 400 keV 之间,而 EPMA 中仅为 5 – 30 keV),弹性碰撞和非弹性碰撞的平均自由程均随电子能量的增加而增大,进一步降低了散射效应。
对于薄样品而言,提高加速电压能够有效减小电子束与样品的总相互作用体积,从而获得更局部化的 X 射线信号源,实现更高的空间分辨率(见图1A)。然而,这一规律并不适用于块体样品,对于块体样品,提高电压反而会增大相互作用体积,其空间分辨率最佳仅能达到0.5 – 1μm(见图1B)。

图 1 (A) 103 个电子穿过 100 nm 铜箔的蒙特卡罗模拟;(上图)100 kV;(下图)300 kV。(B) 相反,在块体样品中,30 kV 下的相互作用体积远大于 10 kV 下的体积,因此较高电压下的 X 射线空间分辨率更差。两组模拟中的颜色反映了电子的能量变化。
目前,利用极低电压电子束和低能X射线谱线降低SEM-EDS空间分辨率的研究备受关注,在入射电子能量(E₀)<5 keV 时,已实现<100 nm 的空间分辨率,像差校正器和探测器进步将进一步助力这一目标的达成,但样品减薄仍是获得最佳空间分辨率的唯一选择。
空间分辨率的定义与测量
长期以来,分析体积(决定空间分辨率)被普遍认为由电子束与样品的相互作用体积决定,因为EDS 可检测该体积内任何位置产生的 X 射线。相互作用体积受入射束直径(d)和束展宽(b)影响,这使得空间分辨率(R)的定义和测量变得复杂。
XEDS 的空间分辨率被定义为样品中两个可进行独立分析的体积之间的最小距离(R)。入射束直径(d)为高斯电子强度分布的 90% 最大值处全宽(FWTM),可通过 TEM 图像直接测量,或通过电子束扫过锐边并观察 STEM 屏幕上的强度变化间接测量。但这一定义仅考虑了进入样品的 90% 电子,且只有在谨慎选择小尺寸的聚光镜 2(C2)光阑并正确对中,同时将电子束限制在近轴条件下时,入射束的电子强度分布才呈高斯分布。
束展宽(b)是电子束穿过样品时发生的散射扩展,其大小由入射束能量(E₀)、TEM样品厚度(t)和原子序数(Z)决定。在大多数分析条件下,“单次散射” 模型可提供良好的近似,该模型由戈德斯坦(Goldstein)等人提出并经琼斯(Jones)用国际单位制(SI)重新定义为:

(式中,b 和 t 的单位为米(m),E₀的单位为千电子伏特(keV),Nv 为原子数密度(单位:原子 / 立方米,atoms/m³))。
对于原子序数(Z)差异极大的元素构成的复杂体系,单次散射模型难以准确估算束展宽(b),此时蒙特卡罗计算机模拟成为最佳替代方案(见图2)。该模拟通过随机方式模拟电子穿过特定样品的一系列可行路径,能纳入不同电压和束直径的影响,处理复杂的样品几何形状等问题,快速提供估算复杂微观结构中束展宽所需的信息。

图2 | 电子穿过两种不同原子序数(Z)金属界面的蒙特卡罗模拟轨迹。高原子序数(Z)区域的电子散射急剧增加,因此 X 射线将来自更大的区域,从而降低局部空间分辨率。
在定义了入射束直径(d)和束展宽(b)后,空间分辨率(R)可通过平方和开方的方式将二者相加得到(如同图像分辨率的计算方法),即R=√(d²+b²)。基于高斯模型和实验测量,迈克尔(Michael)等人提出应在TEM样品中部定义空间分辨率(R),其中最大空间分辨率(Rmax)由相关公式给出(见图3)。这一定义虽忽略了晶体样品中电子衍射的影响以及 90% 极限以外的束尾效应,但已被证明与实验结果和复杂的蒙特卡罗模拟一致,且形式简洁易于计算。
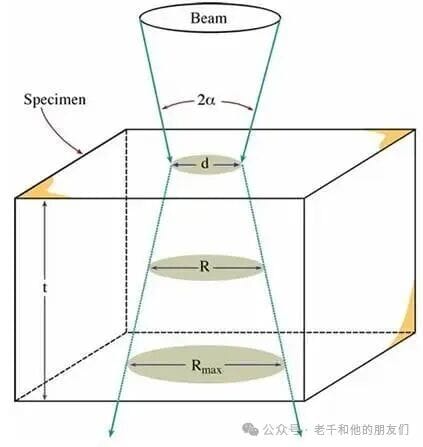
图3 | 入射束尺寸与束展宽共同导致出射探针直径劣化至最大空间分辨率(Rmax),进而定义空间分辨率(R)的示意图。
空间分辨率的实验测量可通过原子级锐界面的成分分布曲线实现(见图4)。将相界面样品作为测量对象具有诸多优势,其界面两侧处于热力学平衡状态时,各相的溶质含量明确,且相界面在许多工程材料中普遍存在。

图4 原子级不连续成分变化界面的成分分布曲线测量示意图。空间分辨率可定义为测量分布曲线在 2% 和 98% 点之间的延伸范围(L)。
通过测量分布曲线上 2% 和 98% 点之间的距离 L,可根据 R=1.414L 计算空间分辨率(R)。由于实验数据存在误差,测量 2% 和 98% 点较为困难,也可测量 10% 和 90% 点之间的距离(对应半高全宽 FWHM),再乘以 1.8 得到 90% 最大值处全宽(FWTM)。
空间分辨率的优化
要提高空间分辨率,必须同时减小入射束直径(d)和束展宽(b)。但减小入射束直径(d)会降低入射束电流,对于热电子源,若入射束直径(d)<10 nm,计数率将低至无法接受。而使用场发射枪(FEG)可在 1 nm 的小束直径下产生足够的电流(1 nA),从而实现高空间分辨率的定量分析。
200 – 300 kV 场发射枪(FEG)TEM 是最佳的高分辨率分析仪器,球差(Cs)校正技术可进一步提高分辨率,在将探针尺寸减小 3 倍的同时,保持相同的探针电流(见图5)。此外,具有更大收集角的新型 X 射线探测器也能为空间分辨率的提升提供助力。

图5 配备和未配备球差(Cs)校正器的 VG HB-603 型 300 kV FEG- STEM的模拟探针图像;(A) 探针的平面尺寸,(B) 三维强度分布。模拟采用相同的探针电流(0.5 nA),球差(Cs)校正使 90% 最大值处全宽(FWTM)探针尺寸从 1.1 nm 减小至 0.4 nm。(C) 计算铜 – 锰(Cu-Mn)合金中,随着箔材厚度减小,球差(Cs)校正对空间分辨率的影响。箔材厚度为零时,分辨率也从略大于 1 nm 提升约 3 倍,达到 0.4 nm。
样品漂移是限制实验空间分辨率的重要实际因素,若样品或探针因机械或电学原因发生漂移,应使用漂移校正软件。尤其是在进行最高空间分辨率的分析时,需要长时间计数以积累足够的 X 射线强度,此类软件更是必不可少。
TEM样品厚度测量:方法与应用
TEM样品厚度(t)的精准测量至关重要,因为束展宽与 t³/² 相关,其不仅影响空间分辨率的估算,也是校正特征 X 射线吸收的关键参数,同时在高分辨率相位衬度成像、会聚束电子衍射(CBED)以及电子能量损失谱仪(EELS)中最佳电离边光谱的获取等场景中都发挥着重要作用。
TEM样品厚度(t)指的是电子束穿透样品的距离,它不一定与零倾斜时的真实厚度(t₀)相同,其与样品的倾斜角(γ)和零倾斜时的真实厚度(t₀)存在 t = t₀/cosγ 的关系(见图6)。若样品为楔形,则TEM样品厚度(t)和零倾斜时的真实厚度(t₀)将根据TEM样品形状随机变化。

图6 (A) 样品零倾斜时,平行面箔材的真实厚度(t₀)等于电子束穿过样品的距离(t)。(B) 样品倾斜角度(γ)后,电子束穿过样品的距离(t)更长,因此倾斜箔材中的束展宽更大。
目前存在多种TEM样品厚度测量方法,每种方法都有其适用场景和局限性。
TEM 法:适用于楔形晶体样品。通过倾斜样品至双束条件以产生强动力学衍射,明场(BF)和暗场(DF)图像会出现厚度条纹,计数从样品边缘到分析区域的暗条纹数量(n),假设边缘最薄处的厚度<0.5ξg,可得出TEM样品厚度(t)=(n – 0.5)ξg(ξg 为消光距离)。
此外,还可利用分析区域附近倾斜平面缺陷的投影图像条纹估算局部厚度(见图 7)。但该方法不适用于非晶材料,且可能忽略晶体样品表面的非晶氧化层厚度,操作中需进行几何校正。与 TEM 图像衬度相关的电子相对透射率测量法适用于所有材料,但操作繁琐且精度不高。

图7 通过倾斜于入射束(夹角为 δ)的平面缺陷(投影宽度为 w)测量样品真实厚度(t₀)所需的参数。比较 (A)(电子束垂直于样品)和 (B)(样品倾斜角度为 γ),可看出确定束展宽方程中合适的箔材厚度(t)的复杂性。
污染点分离法:在(S) TEM中较为常用,适用于样品污染严重的情况。其原理是老旧仪器或受污染的TEM样品会在分析点的样品上下表面产生碳污染点,将样品倾斜足够大的角度(γ),可观察到离散的污染点,根据屏幕放大倍数(M)下污染点的间距(r)计算零倾斜时的真实厚度(t₀)(见图8)。但该方法依赖污染,会遮挡观察区域,降低空间分辨率并增加 X 射线吸收,仅在特殊情况下可用于精确测量分析点的TEM样品厚度(t),且能指示分析过程中电子束或样品是否发生漂移。

图8 污染点分离法测厚示意图;(A) 零倾斜时,污染沉积在样品的两个表面,仅当 (B) 样品倾斜足够大的角度(γ)时,才能观察到污染点的间距(r)。左侧为 STEM 明场(BF)图像,右侧为 STEM 二次电子(SE)图像;二次电子(SE)模式的衬度最佳。(C) (A) 和 (B) 的几何示意图,展示如何通过污染点的投影间距(r)确定零倾斜时的真实厚度(t₀)。
会聚束电子衍射(CBED)法:适用于厚度大于 1ξg、相对平整且无畸变的洁净晶体样品。当会聚束聚焦于样品时,可从 TEM 屏幕上的 K – M 条纹图案中提取厚度信息,是测定晶体样品特定点厚度的理想方法。
电子能量损失谱仪(EELS)法:适用于所有样品(非晶或晶体),测量速度快,且可生成样品厚度分布图。其原理是基于非弹性散射电子的强度随样品厚度增加而增大的特性,通过测量零损失峰下的强度(I₀)与光谱中的总强度(IT)的比值,结合能量损失平均自由程(λ)实现厚度测量。
X 射线光谱法:包括外推法和强度比法,但外推法不适用于局部成分变化的薄箔,强度比法仅适用于原子序数(Z)>20(钙,Ca)的元素的样品。渡边(Watanabe)和威廉姆斯(Williams)提出的 ζ 因子法解决了这些问题,该方法通过迭代过程可同时确定经吸收校正的成分和样品质量厚度,快速且用途广泛,可在进行成分 Mapping 的同时直接生成厚度分布图(见图9),适用于非晶和晶体样品。
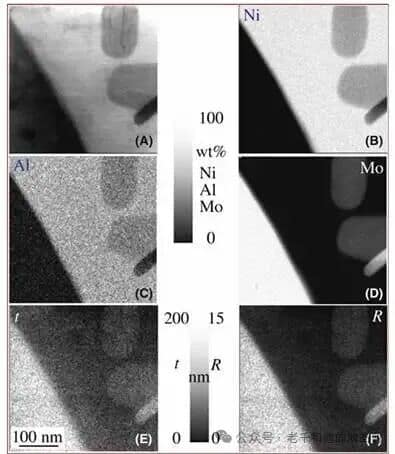
图9 (A) 镍基高温合金中析出相的 STEM 图像和 X 射线 Mapping 图,展示了 (B) 镍(Ni)、(C) 铝(Al)和 (D) 钼(Mo)的定量分布。利用 ζ 因子法可绘制箔材厚度(t)的变化分布图(E)。已知箔材厚度(t)后,还可绘制空间分辨率(R)分布图(F)。注意不同原子序数的复杂相互作用以及由此导致的空间分辨率(R)变化。
总体而言,电子能量损失谱仪(EELS)法和 ζ 因子法因具有广泛实时应用的潜力且可生成厚度分布图,是较为推荐的两种方法;会聚束电子衍射(CBED)法适用于晶体的单点分析。
最小检测限:定义、影响因素与突破
最小检测限的定义与核心关系
最小检测限是指在特定统计置信度下,可检测到的某一特定元素的最小含量,主要有两种定义方式:一是最小质量分数(MMF),表示元素的最小浓度(如质量分数 wt% 或百万分之一 ppm),材料科学家更习惯于使用这一指标;二是最小可检测质量(MDM),描述可检测到的最小物质质量(如克 mg 或原子数)。
所有分析技术都存在一个共性规律:在其他因素相同的情况下,空间分辨率的提升必然伴随着检测限的劣化。随着空间分辨率的提高,分析体积减小,信号强度降低,导致采集的光谱噪声增大,痕量元素的小峰更难检测,且更容易与伪峰混淆。图.10 对比了电子探针(EPMA)、热电子源 TEM/STEM 和专用场发射枪(FEG)STEM 的分析体积大小,电子束– 样品相互作用体积的大幅减小解释了 TEM 中信号水平较低的原因。不过,球差(Cs)校正技术可在更小的探针中获得更大的电流,有效缓解了这种传统的权衡关系。
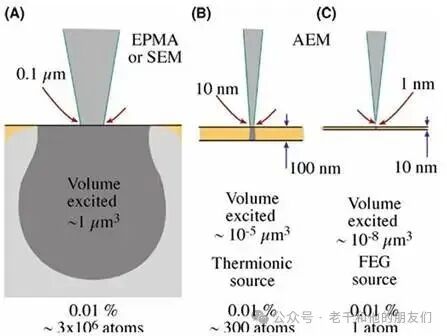
图10 | (A) SEM/ EPMA、(B) 热电子源和 (C) 场发射枪(FEG)AEM分别对块体、薄样品和超薄样品的电子束 – 样品相互作用体积相对大小的比较。在每个分析体积中,0.01% 的最小质量分数(MMF)分别对应约 3×10⁶个原子、300 个原子和<1 个原子。
影响最小质量分数(MMF)的因素
齐博尔德(Ziebold)的表达式将最小质量分数(MMF)与分析的实际操作参数相关联,其中 P 为目标元素特征峰(背景以上)的 X 射线计数率,P/B 为该峰的峰背比(此处定义为峰和背景的宽度相同),τ 为每次分析的时间,n 为分析次数。
要提高 P,可通过增大探针尺寸和/或选择更厚的分析区域来增加束电流,TEM 设计的改进(如使用高亮度中压源、配备球差(Cs)校正器以及 EDS 的更大收集角)也会对 P 的提升产生积极作用。提高 P/B 则可通过提高工作电压(E₀)和降低仪器对背景的贡献来实现,这需要仪器稳定且真空环境洁净,以最大限度减少或消除样品损伤和污染,同时改进样品台设计以减少杂散电子和轫致辐射(二者均会为检测到的光谱贡献背景)。
分析时间 τ 和分析次数 n 完全由操作员控制。在计算机控制分析过程的情况下,分析时间可延长至数小时甚至过夜,但需确保 TEM 洁净(最好是超高真空 UHV)且样品在电子束下洁净稳定,同时若样品发生漂移,必须通过计算机控制进行校正。
最小质量分数(MMF)的统计判据与相关定义
从纯统计角度来看,若峰强度大于峰下背景计数标准偏差的三倍,则可确认峰的存在。基于该判据,结合克利夫–洛里默方程(假设高斯统计),可得出元素A中元素B的最小质量分数(MMF)。
实验中,薄样品的计数率较低,因此最小质量分数(MMF)的典型值在 0.1 – 1% 范围内。在保持X射线空间分辨率的同时提高最小质量分数(MMF)的最佳折中方案是使用高工作电压(300 – 400 kV)和薄样品,以最大限度减少束展宽,同时利用更高的电压和/或场发射枪(FEG)(可维持 1 – 2 nm 的小光斑尺寸)补偿因使用薄样品导致的 X 射线强度(P 或 I)损失,球差(Cs)校正 TEM 也能在此过程中发挥重要作用(见图 11)。
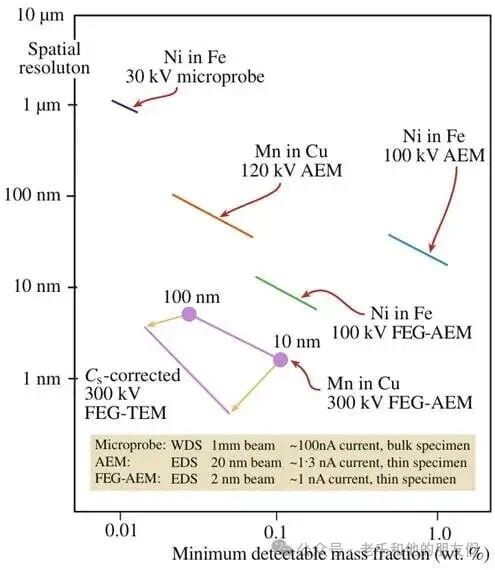
图11| EPMA和一系列AEM的最小质量分数(MMF)与空间分辨率(R)关系的计算结果。MMF与R的反比关系清晰可见,但同样明显的是, AEM中的高亮度源和高电压电子束可补偿薄箔中相互作用体积减小的影响。球差(Cs)校正使分辨率和灵敏度均得到极大提升。
柯里(Currie)指出分析化学文献中至少存在八种最小检测限的定义,并定义了三个特定的限值:判定限(LC),用于判断分析结果是否表明检测到目标元素;检测限(Ld),用于评估特定分析流程是否可靠地实现目标元素的检测;定量限(Lq),用于判断特定分析流程的精密度是否足以实现目标元素的满意定量。
对于特定峰窗口中元素 B 的背景计数(IBb),当 IBb>2500 时,Ld=√(14.1IBb)。将这些定义与前述统计判据进行比较,可发现最小质量分数(CMMF)≈检测限(Ld),而要对元素进行定量分析,样品中该元素的含量需达到检测限的3倍左右。在开展实验前,可使用剂量与光谱分析软件(DTSA)进行模拟分析,判断目标元素的含量是否高于最小质量分数(MMF)。
最小可检测质量(MDM)的优势与突破
与其他报告百万分之一(ppm)甚至十亿分之一(ppb)检测限的分析技术相比,TEM 的最小质量分数(MMF)看似较差,但将其转换为最小可检测质量(MDM)后,其优势便十分显著。
莱曼(Lyman)和迈克尔(Michael)的实验表明,使用配备场发射枪(FEG)的 VG HB – 501 型分析电子显微镜(AEM),在 164 nm 厚的 304L 不锈钢TEM样品中,铬(Cr)的最小质量分数(MMF)为 0.069 质量分数(wt%),空间分辨率为 44 nm,计数时间为 200 s 时,可检测到 2×10⁴个原子,最小可检测质量(MDM)小于 10⁻¹⁹克(g)。
若计数时间增加10倍,工作电压提高至300 kV,空间分辨率将提升至15 nm,最小质量分数(MMF)将改善至 0.01 质量分数(wt%),可检测到约300个原子;对于 16 nm 厚的TEM样品,最小质量分数(MMF)虽劣化至0.03 质量分数(wt%),但空间分辨率将提升至约2 nm,可检测到约20个原子,对应最小可检测质量(MDM)小于10⁻²² 克(g)。
渡边(Watanabe)和威廉姆斯(Williams)于1999年在10 nm 厚的铜–锰(Cu – Mn)合金薄膜中检测到了2 – 5 个锰(Mn)原子。
随着球差(Cs)校正技术的出现和计算机数据分析程序的改进,单原子检测现已成为现实(见图12)。图13 展示了在球差(Cs)校正、300 kV、超高真空(UHV)、场发射枪(FEG)STEM 中,从均匀铜– 0.5 质量分数(wt%)锰(Mn)TEM样品获得的一系列定量 Mapping 图,清晰呈现了锰(Mn)的成分分布、样品厚度分布以及锰(Mn)原子数分布,其中占主导地位的紫色对应 2 – 3 个原子。

图12 基于 300 keV FEG-STEM 中锰(Mn)Kα 峰的实验计数(绿色圆圈),计算表明,球差(Cs)校正器(红线)可将最小可检测质量(MDM)从多个原子改善至检测限处的 1 个原子。

图13 在球差(Cs)校正、300 kV、超高真空(UHV)、FEG-STEM 中,从均匀铜 – 0.5 质量分数(wt%)锰(Mn)箔材获得的一系列定量 Mapping 图。
与电子探针(EPMA)相比,配备最佳球差(Cs)校正、中压、超高真空(UHV)、场发射枪(FEG)的 TEM 中的 EDS,其最小可检测质量(MDM)检测限高出数百万倍。
尽管先进的TEM- EDS组合已达到原子级检测(见下图),未来可通过增大收集角和采用更复杂的数据处理技术进一步提升其性能。

Ga、As、In、Sb 元素的 EDS 原子级面分布图,叠加于高角环形暗场(Z 衬度)像上。
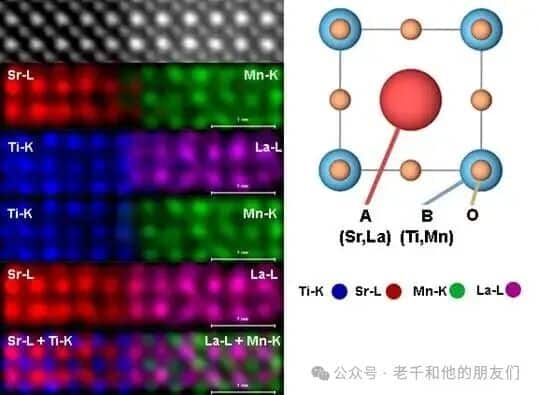
用于解析 STO/LSMO 界面原子尺度结构的 EDS 面分布图;左侧为不同的元素复合面分布图,右侧为钙钛矿晶体结构示意图。
总结与展望
在TEMX 射线分析中,空间分辨率与最小检测限的优化始终存在权衡关系。
若以获得最佳空间分辨率为目标,应使用最薄的TEM样品和最高能量的电子束,优先选择场发射枪(FEG),并尽可能配备球差(Cs)校正器;若需精准测量样品厚度,ζ 因子法或参数化电子能量损失谱仪(EELS)法是首选,若这两种方法均不可行,对于晶体TEM样品可采用会聚束电子衍射(CBED)法,若只能使用污染点分离法,则需考虑更换性能更好的 TEM 或制备更洁净的样品;若要获得最佳最小质量分数(MMF),应选用最亮的电子源、尽可能大的电子束和最厚的样品,并在最短时间常数下尽可能延长计数时间。
若需同时获得最佳分辨率和最小质量分数(MMF),则必须使用球差(Cs)校正、中压、超高真空(UHV)、场发射枪(FEG)TEM,同时配备洁净的样品和计算机控制的漂移校正系统,耐心细致地开展实验。
随着相关技术的持续进步,TEM X 射线分析在空间分辨率和最小检测限方面的性能将不断突破,为材料科学等领域的研究提供更强大的技术支撑。
参考资料Spatial Resolution and Minimum Detection
Atomic Resolution EDS | Energy Dispersive X-ray Spectroscopy


