作者:孙千 本文转载自公众号:老千和他的朋友们。原文地址:https://mp.weixin.qq.com/s/o5XOS4GfSDE38o22fIAA8g
电子能量损失谱(EELS)是分析型电镜(AEM)里的核心表征技术,简单来说,它就是通过分析高能电子穿过样品后的能量分布情况,来获取样品的原子化学性质、电子结构、微观结构等关键信息的技术。
当高能电子穿过样品时,会发生两种碰撞:一种是弹性碰撞,电子不会产生能量损失;另一种是非弹性碰撞,大多是电子之间的相互碰撞,电子会因此损失能量。而这些能量损失的过程中,藏着样品的诸多细节,比如原子的成键方式、原子价态、相邻原子的结构、自由电子密度,若是样品有带隙也能检测出来,甚至还能判断样品厚度,这也是 EELS 能成为电镜核心技术的原因。
EELS 和我们常接触的 EDS 并不是相互替代的关系,而是互补的,二者搭配能实现更全面的样品表征。EDS 能识别并定量分析元素周期表中锂及以上的所有元素,空间分辨率能达到几个原子的级别,分析灵敏度接近单原子水平,而且操作比较简单,对样品的厚度要求也不高;
EELS 的优势则更突出,它能检测和定量分析周期表中的所有元素,对轻元素的分析效果尤其好,空间分辨率和分析灵敏度都能达到单原子级别,还能提供远超单纯元素识别的信息,比如电子结构、原子成键状态等。
当然 EELS 也有局限性,它需要极薄的样品才能得到最佳的实验结果,而且解读、处理它的谱图和图像,需要科研人员具备更多的物理学背景知识。所以大多数分析型电子显微镜,都会同时配备 EELS 和 EDS 两种谱仪。
非弹性散射的双重影响
非弹性散射是 EELS 技术的核心基础,但它对实验结果的影响有好有坏,是一把 “双刃剑”。
从有利的方面来看,非弹性散射会让衍射花样中出现菊池线和高阶劳厄带线,这些线的电子衍射角度和布拉格角非常接近,能为科研人员提供比选区电子衍射、会聚束电子衍射花样更精准的晶体学信息,这一点在分析较厚的样品时特别有用。
同时,非弹性散射产生的能量损失电子,承载着样品电子结构和元素组成的关键信息,若是电镜配备了能量损失谱仪或过滤器,这种散射过程正是实验所需要的 —— 如果没有非弹性散射,透射电镜的实用性会大打折扣。
从不利的方面来看,非弹性散射会让衍射花样中直射束的周围出现背景强度,把选区电子衍射花样中的微弱斑点、会聚束电子衍射花样中的精细细节掩盖住;而且损失了能量的电子,在电镜物镜中会走不同的路径,引发色差效应,限制厚样品的成像分辨率;除此之外,非弹性相互作用还可能造成样品损伤,这一问题目前还没有有效的解决办法。
不过好在通过能量过滤技术,去除特定能量的非弹性电子,就能有效消除色差,提升图像和衍射花样的质量,这一技术也推动了能量过滤透射电子显微镜(EFTEM)的发展。
EELS 谱图的核心特征
EELS 谱图是解读样品信息的关键,它的典型特征和电子的能量损失规律紧密相关,以 50 电子伏特(eV)为大致分界,谱图能分成低损失区和高损失区两个部分,而且整体需要用对数刻度展示,因为谱图的强度范围极大。

图1对数强度模式下显示的EELS。零损失峰的强度比低损失区(以等离子体峰为特征)高一个数量级,而低损失区的强度又比高损失区中识别出的微弱电离边高多个数量级。注意相对较高(且快速变化)的背景。
谱图中最显眼的特征是零损失峰,它的强度极高,这既是实验中的优势 —— 可以把它作为电镜聚焦和谱仪校准的基准,也有一定弊端 —— 强度占比太大会影响其他峰的观察。
低损失区对应的是能量损失≤50eV 的区域,这里包含的是样品中结合较弱的传导带和价带电子的信息,其中的等离子体峰强度相对较高;高损失区则是能量损失 > 50eV 的区域,主要包含结合较强的芯层电子的元素信息,还有原子成键、原子分布的相关细节,这里有被称为电离边的元素特征峰,只是这个峰和背景相比,强度相对较低。
还有一个关键特点,EELS 谱图的整体信号强度会随着能量损失的增加快速下降,当能量损失超过 2000eV(2keV)时,信号强度会降到几乎可以忽略的水平,这也划定了 EELS 的能量检测极限。而这个能量范围,恰好是 EDS 发挥作用的核心区域,这也进一步体现了 EELS 和 EDS 的互补性。
EELS 核心仪器与工作原理
磁棱镜谱仪(PEELS)
检测电子能量谱的核心器件是磁棱镜谱仪,其能量分辨率极高,即便电子束能量高达 300 千电子伏特(keV),能量分辨率仍能小于 1 电子伏特(eV)。目前商业化的谱仪主要是 Gatan 公司生产的并行采集电子能量损失谱仪(PEELS),它是一种磁棱镜(有时也称为磁扇区)系统,安装在 TEM 或扫描透射电子显微镜(STEM)的观察屏或样品后探测器之后。
PEELS 的工作原理与玻璃棱镜色散白光类似,电子通过可变入射光阑(Gatan 系统中光阑直径可选 1、2、3 或 5 mm)进入谱仪后,沿着 “漂移管” 穿过谱仪,在磁场作用下偏转≥90°。由于损失能量的电子比零损失电子偏转角度更大,因此会在色散平面上形成由电子强度(I)随能量损失(ΔE)分布构成的谱图(如图2 所示)。

图2 (A) 并行采集电子能量损失谱仪(PEELS)与TEM观察屏下方连接方式及各部件位置示意图。
与玻璃棱镜不同的是,磁棱镜还兼具磁透镜功能,能量损失相同但沿同轴和离轴方向传播的电子,能在谱仪的色散(或成像)平面上重新聚焦,这种 “双聚焦” 特性是通过将谱仪的入射面和出射面加工成与轴向电子不垂直的形状实现的(如图2B、C 所示),图3 展示了 Gatan 谱仪(组合成像谱仪)的实物图。

图2 | (B) 磁棱镜谱仪的光路图,展示了零损失电子和能量损失电子在谱仪成像(色散)平面中的不同色散与聚焦情况。插图为玻璃棱镜色散白光的类比示意图。(C) 垂直于谱仪平面内的透镜聚焦作用。

图3 | 一款连接在电镜(AEM)观察屏下方的 Gatan Tridiem 并行采集电子能量损失谱仪(PEELS)。
谱仪的聚焦是实验成功的关键环节之一。最新的谱仪已完全校正了三阶像差,对准、杂散交流场补偿和聚焦均由软件控制。谱仪的物平面取决于仪器具体结构:无样品后透镜的专用扫描透射电子显微镜(DSTEM)中,物平面是样品平面;在 TEM和常规STEM 或带有样品后透镜的 DSTEM 中,镜筒后谱仪的物平面是投影镜的后焦面(可呈现图像或衍射花样),镜筒内过滤器的物平面则是第一投影镜(或中间镜)的后焦面。
实际操作中,可通过观察零损失峰(ZLP)的高斯形强度分布,调整谱仪前四极杆,使 ZLP 达到最小宽度和最大高度,从而完成聚焦。
谱仪的色散和分辨率是影响实验精度的核心参数。色散定义为能量差为 dE 的电子在谱图中的距离(dx),是磁场强度和入射束能量 E₀的函数,对于 Gatan 磁体,100 keV 电子的色散 dx/dE 为 2 mm/eV,需通过谱仪后透镜放大 15 倍才能实现接近 1 eV 的分辨率。
能量分辨率则定义为聚焦后的零损失峰(ZLP)的半高宽(FWHM),其性能由电子源类型决定:100 keV 下,钨(W)源约 3 eV,六硼化镧(LaB₆)源约 1.5 eV,肖特基场发射枪(Schottky FEG)可达 0.7 eV,冷场发射枪(cold FEG)最佳,为 0.3 eV(如图4A 所示)。

图 4:(A) 200 keV 电压、150 pA 电流下冷场发射枪(cold FEG)的能量分辨率(0.37 eV),由零损失峰(ZLP)的半高宽(FWHM)确定。该峰不对称,原因是电子从尖端隧穿逸出时存在轻微(<1 eV)的能量损失。
此外,加速电压升高、外部磁场干扰等因素会导致分辨率下降,而通过减小投影镜交叉点、选用较小入射光阑(1 或 2 mm)等方式,可提升能量分辨率。
谱仪校准需以 eV / 通道为单位,常用两种方法:一是在漂移管上施加精确已知的电压,二是轻微改变加速电压,通过零损失峰(ZLP)的已知位移确定校准参数(如图4B 所示)。对于早期系统,也可利用已知样品的特征峰(如 0 eV 处的零损失峰和 855 eV 处的镍 L₃电离边)进行校准。由于校准值可能发生轻微漂移(几 eV 漂移即影响分析结果),操作过程中需定期检查。

图4 | (B) 零损失峰在电荷耦合器件(CCD)相机上的强度分布,随后偏移 10 eV 再次曝光。由半高宽定义的分辨率在此情况下为 1.1 eV,若计数峰中心之间的通道数(例如 100 个通道),则可轻松计算出色散(0.1 eV / 通道)。
能量过滤器
能量过滤器是实现 EFTEM 技术的核心器件,既能产生谱图,又专为成像设计,主要分为镜筒内(Ω)过滤器和镜筒后 Gatan 图像过滤器(GIF)两类。
镜筒内 Ω 过滤器是原始卡斯泰恩–亨利(Castaing-Henry)磁棱镜/静电镜的磁变体,以蔡司(Zeiss)首创的 Ω 过滤器为代表,如今日本电子(JEOL)也在使用。它集成在 TEM 内部,位于样品和观察屏/探测器之间,由一组呈 Ω 形排列的磁棱镜组成,电子在磁场作用下偏离光轴后,最终会重新回到光轴上(如图5A 所示)。
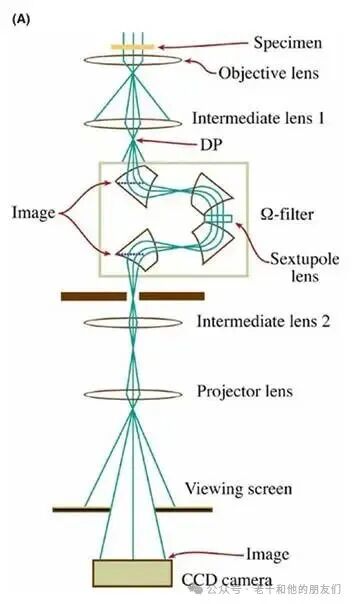
图5 (A) 插入透射电子显微镜(TEM)成像透镜系统的柱内 Ω 过滤器示意图。
通过镜筒内过滤器进行 EFTEM 成像时,谱仪的入射光阑选择样品的一个区域,收集半角 β 由物镜光阑控制,谱仪后狭缝则选择特定能量范围的电子用于成像(如图5B 所示)。

图5 (B) 生成能量过滤透射电子显微镜(EFTEM)图像所需步骤的光路示意图。
若调整投影镜焦点至过滤器的色散平面并移除狭缝,观察屏 / CCD 上会呈现强度随能量变化的线状谱图(如图6A 所示),通过计算机处理可转化为传统谱图形式(如图6B 所示)。

图6 (A) Ω 过滤器获得的谱图,线的轴为能量损失,强度沿该线变化。(B) 由 (A) 得到的传统强度 – 能量损失谱图。
镜筒后 GIF 基于 Gatan PEELS 发展而来,安装在 TEM 观察屏下方,可选择使用或关闭。它在磁体后增加了能量选择狭缝,并采用二维慢扫描 CCD 探测器而非一维光电二极管阵列(PDA),其光学系统包含更多四极杆和六极杆,用于实现谱图放大、色散补偿和像差校正(如图7A、B 所示)。
GIF 可切换两种工作模式:一是将选择狭缝平面上的谱图图像投影到 CCD 上,类似标准 PEELS;二是将样品的放大图像投影到 CCD 上,形成由特定能量电子构成的过滤图像或衍射花样。不过,GIF 的放大倍数可能导致 TEM 观察屏的实际放大倍数需设置得较小,部分显微镜难以补偿这种差异,需在 TEM 图像和 GIF 图像之间切换。

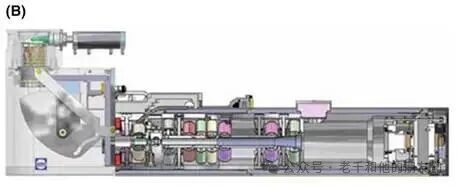
图7 (A) 柱后成像过滤器与透射电子显微镜(TEM)镜筒连接的示意图,安装在观察室下方,与并行采集电子能量损失谱仪(PEELS)位置相同。(B) Gatan(Tridiem)成像过滤器(GIF)的横截面,展示其复杂的内部结构。
单色器
能量分辨率是 EELS 技术的关键指标,尤其在研究原子振动模式、带间/带内激发、精细结构和电子效应等方面,亚eV分辨率至关重要。当谱仪不是限制因素时,电子枪决定了最终的能量分辨率,而商业化单色器的出现进一步突破了分辨率极限——其分辨率可达 100 meV,在极低能量损失(<50 eV)下甚至能达到 25 meV。
单色器本质上是一种安装在场发射枪(FEG)源上的 EELS 系统,通常为维恩过滤器(Wien filter),内部具有垂直的静电场和磁场,能使选定能量的电子沿直线穿过 TEM 镜筒,进一步细化电子能量分布。
如图8A 所示,有无单色器对零损失峰(ZLP)的半高宽(FWHM)影响显著,商业化单色器的 ZLP 半高宽远优于肖特基枪(600 meV),略优于性能良好的冷 FEG(300 meV)。图8B 对比了不同仪器获得的钴(Co)L₂,₃边谱图与计算谱图,可见单色器 FEG 的谱图质量与同步辐射源的谱图相近,仅噪声略高,与计算谱图的吻合度极佳。
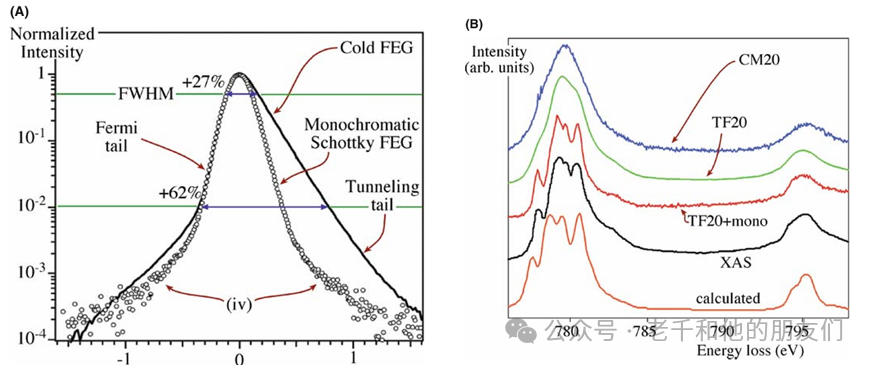
图8 (A) 冷场发射枪(cold FEG)在有无单色化处理时的典型零损失峰(ZLP)。注意纵坐标为对数坐标,因此半高宽(FWHM)在视觉上接近峰的顶部。(B) 不同仪器获得的钴 L₂,₃边谱图与计算谱图对比:飞利浦 CM20 热离子源、配备冷场发射枪的 FEI Tecnai TF20、配备单色器的 TF20、同步辐射源(X 射线吸收谱)以及基于晶体场理论的计算谱图。单色化处理后分辨率的提升十分明显。
需注意的是,单色化存在明显权衡:为减小 ZLP 半高宽而过滤掉高斯能量分布的尾部,会导致电子数量显著减少,且开启单色器后,几乎所有其他 TEM/AEM 操作的性能都会下降。因此,仅当高分辨率 EELS(HREELS)是仪器主要用途时,才建议配备单色器;若无需绝对最佳分辨率,通过反卷积程序也能获得约 200 meV 分辨率的谱图,是更经济的替代方案。
EELS 的操作与数据采集
操作模式
在 TEM/STEM 中使用 EELS 谱仪或过滤器时,主要有两种操作模式,需注意区分相关术语:成像模式(TEM 观察屏上呈现图像)和衍射模式(TEM 观察屏上呈现衍射花样,包括 STEM 模式)。
本文采用显微分析人员的术语:成像模式仅适用于 EFTEM 成像,不适用于谱学分析;除 EFTEM 成像外,所有谱学分析和成像都应使用衍射(或 STEM)模式。早期文献中术语使用较为混乱,但目前显微分析人员的术语已被普遍采用。
收集半角(β)的确定
收集半角 β 是 EELS 实验的关键变量,定义为谱仪或过滤器的入射光阑在样品处形成的半角,其数值直接影响实验数据的质量和解读,是定量分析中最常见的误差来源(β 值较大时影响相对较小)。特定损失过程存在特征散射角,通常 β 应设置为该角度的 2-3 倍,若不确定可设置得更大一些。
不同仪器和操作模式下,β 的计算方法不同:在无样品后透镜的基础型 DSTEM 中,可通过几何关系近似计算(β≈d/(2h),d 为谱仪入射光阑直径,h 为样品到光阑的距离),例如 h=100 mm、直径 1 mm 的光阑对应的 β=5 毫弧度(mrads)(如图9所示);
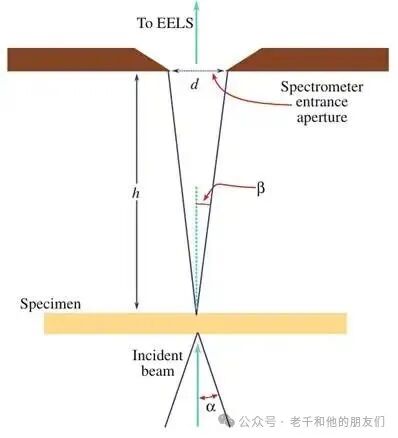
图9 | 专用扫描透射电子显微镜(DSTEM)中 β 定义的示意图,该电镜的样品与谱仪入射光阑之间无透镜。
TEM 成像模式下,β 由物镜光阑控制,若已知物镜光阑尺寸和物镜焦距,可通过类似几何关系计算(β≈物镜光阑直径 /(2× 物镜焦距)),例如焦距 3 mm、光阑直径 30 mm 时,β=5 mrads(如图10所示);

图10 TEM成像模式下 β 值由物镜后焦面(BFP)中的物镜光阑尺寸决定。
TEM/STEM 衍射模式下,β 由所选谱仪入射光阑控制,需通过已知晶体样品的衍射花样校准(如图11所示),也可利用公式 β=(D/D_A)×(d/L) 计算(D 为投影镜交叉点到记录平面的距离,D_A 为交叉点到入射光阑的距离,d 为光阑直径,L 为相机长度),例如 Gatan PEELS 系统中 D_A=610 mm,D=500 mm,L=800 mm,直径 5 mm 的光阑对应的 β=5 mrads。

图11 | TEM/STEM衍射模式下 β 值由投影到衍射花样(DP)平面的谱仪入射光阑尺寸决定。可通过参考已知衍射花样校准该尺寸。
空间选择
谱图的获取源自样品的不同区域,具体取决于操作模式:TEM 成像模式下,待分析区域需定位在光轴上、入射光阑上方,所选区域大小由光阑尺寸缩小到样品平面后的尺寸决定,但由于色差效应,实际空间分辨率会大幅下降(约 100 nm 偏移),不建议用于高空间分辨率分析;TEM 衍射模式下,可通过选区电子衍射(SAD)光阑或 STEM 细束选择样品区域,所选区域宽度通常 <~50 nm,最适合高空间分辨率 EELS 分析,尤其推荐保持束扫描并在每个点收集谱图(即谱成像),以消除点分析或线分析的主观性偏差。
谱图采集设备
谱图的记录装置经历了从照相胶片、PDA 到 CCD 的发展历程,如今 CCD 已成为主流探测器。与 PDA 相比,CCD 具有增益变化小、灵敏度高 30 倍、动态范围大以及能量分辨率更高等优点。
Gatan PEELS 采用钇铝石榴石(YAG)闪烁体,通过光纤与 PDA 或 CCD 耦合:PDA 由 1024 个电隔离且经过热电冷却的硅二极管组成,每个二极管饱和计数为 16,000,需控制积分时间避免饱和,可通过多次积分求和提升谱图质量;CCD 探测器为 20 mm 像素组成的 100×1340 阵列,不易饱和,采集过程更简便。积分完成后,谱图通过放大器经模数转换器(A/D converter)读出并传输至计算机显示系统,Gatan 软件提供了多种适用于不同类型谱图的标准采集条件。
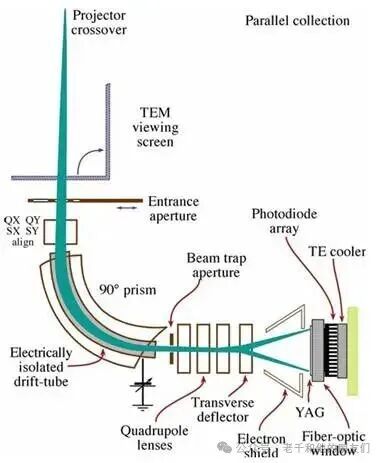
图12 能量损失谱并行采集到钇铝石榴石(YAG)闪烁体的示意图,该闪烁体通过光纤与半导体光电二极管阵列(PDA)耦合。
PEELS 的常见问题与解决方案
点扩散函数(PSF)
在 PEELS 中,若将零损失峰(ZLP)聚焦到 PDA 的单个通道或 CCD 的单个像素,整个探测阵列上的强度分布即为点扩散函数(PSF),这一系统伪影会降低磁谱仪的固有分辨率,使谱图中的特征峰(如电离边)变宽(如图13A 所示)。通过反卷积处理可消除 PSF 的影响,将谱图分辨率恢复到束的固有分辨率(如图13B、C 所示),商业化软件已实现这一功能,建议对收集到的所有谱图进行常规反卷积。

图13(A) 点扩散函数(PSF),显示强且轮廓清晰的零损失峰(ZLP)在信号从闪烁体通过光纤耦合传输到光电二极管阵列(PDA)或电荷耦合器件(CCD)过程中因扩散而退化。该峰本应占据单个通道,却扩散到多个通道。(B、C) 经零损失峰反卷积后,氮化硼(BN)纳米管的硼 K 边能量分辨率得到提升。原始数据(B)显示硼 K 边的分辨率为 0.68 eV,反卷积点扩散函数后(C)分辨率提升至 0.36 eV。
主要伪影及消除方法
PEELS 系统的伪影主要由 PDA 引起,CCD 探测器可显著减少伪影(仅鬼峰和暗电流仍可能存在)。常见伪影包括:高泄漏电流(尖峰),由故障二极管导致,可通过减去暗电流消除;通道间增益变化,因二极管响应不同,可在阵列的不同部分收集谱图并叠加消除(如图14所示);

图14 | 并行采集电子能量损失谱仪(PEELS)探测系统中单个二极管对恒定入射电子强度的响应变化。通道间增益变化明显,每个探测器阵列均有其独特的特征响应函数。
内部扫描噪声,来自电子读出系统,需调整电子设备并减去暗计数;鬼峰,由二极管饱和或闪烁体过度曝光导致,进行多次读出即可消除(如图15 所示);

图15 无电子束入射时,从光电二极管阵列(PDA)流出的暗电流强度。
非线性响应,由 YAG 闪烁体损坏引起,可通过验证不同读出次数(总积分时间相同)下的零损失强度一致性判断,损坏后需更换闪烁体(如图16所示)。

图16 (A) 钙 L₂,₃边谱图,同时显示通道间增益变化和高泄漏电流的故障二极管(在谱图中表现为尖峰)。该尖峰被称为读出模式,存在于所有记录的谱图中。(B) 暗电流谱图;(C) 减去暗电流后去除尖峰的谱图;(D) 差分谱图,去除了增益变化,得到目标边谱图。
EELS 的主要应用方式
EELS 的应用方式灵活多样,可根据研究需求选择合适的分析方法:
- 点分析:停止 STEM 探针扫描,将其定位在选定位置记录谱图(如图 17A 所示)。该方法操作快捷,适用于样品的初步快速观察,但具有主观性强、统计性差、易损坏或污染样品等缺点,不建议用于常规精确分析。

图17 (A) 铜铬氧化物纳米颗粒的单点分析电子能量损失谱(EELS),显示三种元素信号的局部差异。
- 线分析:沿着感兴趣特征(如平面界面或晶界等缺陷)的一条线收集一系列谱图(如图17B 所示)。虽仍受限于线的选择,但能专注于提供样品关键区域的信息变化(如成分、介电常数等),是研究界面或缺陷特性的有效手段。

图17 | (B) 线扫描谱分析,展示沿氮掺杂碳纳米管 A-B 线的谱图细节变化。插图为单个谱图(标注碳 K 边和氮 K 边)以及扫描透射电子显微镜(STEM)图像(箭头指示线扫描谱分布的采集位置)。
- TEM 过滤图像:使用 GIF 或 Ω 过滤器,通过狭缝选择特定能量的电子成像(如图17C 所示)。过滤掉所有能量损失电子生成的零损失峰(ZLP)图像,能显著提升 CBED 花样的质量;同时,EFTEM 还能改善质量厚度衬度、相位衬度和衍射衬度,提升图像的信息量和清晰度。
- STEM 过滤图像:通过狭缝选择特定能量的电子,使束在感兴趣区域扫描并成像(如图7D 所示)。选择特定元素的特征能量电子,可生成成分分布图,与 XEDS 成分图类似,但在轻元素成分分析中更具优势。
- 谱成像:在 STEM 模式下,每个像素处存储完整的谱图,形成数据立方体。采集完成后,可灵活提取所需信息(如特定能量下的图像、样品中特定点 / 线的谱图),完全消除点分析或线分析的主观性偏差。由于 EELS 更容易收集大量计数,其谱成像比 XEDS 谱成像更易实现,是获取样品全面信息的首选方法。

图17 | (C) 硅 [111] 会聚束电子衍射(CBED)花样的未过滤(左)与能量过滤透射电子显微镜(EFTEM)过滤(右)对比图。(D) 碳化硅 / 氮化硅(SiC/Si₃N₄)纳米复合材料的扫描透射电子显微镜(STEM)能量过滤图像,展示不同元素的分布以及 RGB 彩色叠加合成图(碳:红色,氮:绿色,氧:蓝色)。(D) 碳化硅 / 氮化硅(SiC/Si₃N₄)纳米复合材料的扫描透射电子显微镜(STEM)能量过滤图像,展示不同元素的分布以及 RGB 彩色叠加合成图(碳:红色,氮:绿色,氧:蓝色)。
总结与展望
EELS 技术凭借其超高的能量分辨率、全元素检测能力(尤其擅长轻元素分析)和丰富的信息维度,已成为探针型 TEM 上的主导谱学技术。其核心仪器(磁棱镜谱仪、能量过滤器、单色器)的不断升级,以及操作方法的持续优化,推动了 EELS 在材料科学、电子学、生物学等多个领域的广泛应用。
理解磁棱镜的工作原理、谱仪的聚焦与校准方法、收集半角 β 的确定方式,以及常见问题的解决方案,是成功开展 EELS 实验的基础。EELS 与 XEDS 的互补使用,能最大程度发挥 AEM 的表征能力;而 EFTEM 技术的发展,进一步拓展了 EELS 在成像领域的应用,使图像和衍射花样的质量得到显著提升。
未来,随着像差校正技术、探测器技术和软件算法的不断进步,EELS 的能量分辨率和空间分辨率将持续提升,应用场景将更加广泛。诸如蔡司(Zeiss)亚电子伏特–亚埃显微镜(SESAMe)上的曼陀林过滤器(Mandoline filter)和 Nion 公司的 UltraSTEM 等具有更小像差和更高能量分辨率的系统,将为 EELS 技术带来更多突破性进展。
参考资料Electron Energy-Loss Spectrometers and Filters


