作者:孙千 本文转载自公众号:老千和他的朋友们。原文地址:https://mp.weixin.qq.com/s/bvRckMSpsA0Okjll7HKHQw
原子层沉积(Atomic Layer Deposition, ALD)是一种靠表面反应控制的化学气相沉积技术,如今已成为原子尺度制造领域的核心技术。它最特别的地方在于,能像搭积木一样,以原子为单位精准控制薄膜厚度,还能在复杂的三维结构表面均匀裹上一层薄膜,不管基底是几平方厘米的实验室样品,还是数平方米的工业板材,薄膜厚度偏差都能控制在很小范围。
随着人们对更小的芯片、更耐用的电池、更清晰的显示屏和更高效的太阳能电池的需求越来越高,ALD正横跨化学、材料科学和工程学,给半导体、可再生能源、显示技术等多个领域带来变化。从实验室里的纳米材料研究,到工厂里的大规模生产,ALD的用途越来越广。
本文将讨论ALD的核心原理、技术发展、实际应用。
自限制反应,让沉积精准到原子级
ALD的核心道理其实不复杂,关键在于自限制反应——简单说,就是反应到一定程度会自动刹车,不会无限制进行。和物理气相沉积(PVD)、传统化学气相沉积(CVD)不一样,后两者靠控制气相物质的输送量来调节薄膜厚度,比如PVD像是喷枪喷漆,容易在复杂结构的凹陷处喷不到,传统CVD像是烟雾笼罩,厚度控制不够精细;而ALD是让基底表面轮流接触两种反应物——前驱体和共反应物,每次接触后都用氩气、氮气这类惰性气体吹一遍,把多余的反应物和反应副产品彻底吹走,避免它们在气体中直接反应。
这个前驱体→吹扫→共反应物→吹扫的过程,叫做AB循环。打个比方,前驱体就像带着成膜原子的搬运工,会主动找到基底表面的反应位点并附着上去,等所有位点都被占满,剩下的前驱体就会被吹扫气体送走;接着共反应物登场,它会和前驱体发生反应,去掉多余的配体,让成膜原子牢牢固定在基底上,同时让基底表面重新生出新的反应位点,方便下一轮循环。每完成一次循环,薄膜只会增加固定的厚度,这个厚度增量叫每循环生长量(GPC),通常在0.5到1.5埃之间——1埃是0.1纳米,大概就是几个原子并排的厚度。正因为这样,薄膜最终的厚度完全可以通过控制循环次数来精准调节,比如想要10纳米厚的薄膜,只要找到对应的循环次数,就能精准实现。
ALD的沉积条件还很温和,大多数反应在500℃以下就能进行,比很多CVD工艺需要的700℃以上温度低得多,不会把高分子、钙钛矿这类温度敏感的基底烤坏。而且它不像PVD那样需要高能离子轰击,不会破坏精密的微结构。
这些特点让ALD拥有三大无可替代的优势:一是厚度控制精准到原子尺度,二是在大尺寸基底上(比如半导体工厂的12英寸晶圆),薄膜厚度偏差能控制在1.5%以内,三是能给超高深宽比的结构均匀镀膜,比如芯片里的微小沟槽,热ALD能应对50:1以上的深宽比(沟槽深度是宽度的50倍),等离子体增强型的甚至能达到750:1,这是其他沉积技术根本做不到的。

图 1 原子层沉积(ALD)基础原理
a. ALD循环的示意图:基底表面交替暴露于前驱体(A 步骤)和共反应物(B 步骤),两个反应步骤之间通过吹扫步骤隔离。后续暴露方式可为时间序列型或空间分离型。b. 八次 ALD 循环过程中薄膜厚度线性增长的示意图,图中直线斜率即为每循环生长量(GPC)。c. 自限制表面反应对应的典型饱和曲线。d. ALD 温度窗口随温度变化的形成规律:在 ALD 温度窗口内,可实现自限制薄膜生长,且 GPC 可能随温度变化;超出该窗口温度范围时,可能出现其他非理想效应。注:CVD 为化学气相沉积;T 为基底温度。
四大组件搭起实用的ALD平台
要让ALD发挥作用,得靠四个关键部分默契配合——前驱体、共反应物、反应器和工艺参数,这四样东西经过几十年的打磨改进,才形成了现在好用又可靠的ALD技术体系。

图 2 原子层沉积(ALD)工艺核心要素
展示原子层沉积(ALD)常用的前驱体体系、对应的共反应物、ALD 反应器构型、ALD 循环模式及 ALD 工艺条件。插图为前驱体的示意图,标注了不同成键方式的配体。前驱体根据金属 – 配体配位方式分类;虚线框内的分子中,全氧配位、氧–氮混合配位及全氮配位配体的稳定性从右至左逐渐增强,反应活性从左至右逐渐增强。注:R 代表烷基取代基。
前驱体是成膜元素的源头材料,得满足三个核心要求:容易变成气体(挥发性),这样才能从存储容器顺畅输送到反应区域,不会半路凝结;能和基底表面发生反应(反应性),让成膜原子牢牢留在基底上,不轻易脱落;在沉积温度下不会轻易分解(热稳定性),不然还没到基底就散架,没法完成成膜任务。
一开始的前驱体多是金属卤化物,比如四氯化铪、三氯化铝,虽然稳定性强,但容易在薄膜中留下卤素杂质;后来通过分子设计,出现了杂配体配合物——这种材料的分子结构不对称,就像给金属原子搭配了不同功能的配体手臂,有的负责让它容易变成气体,有的负责让它能精准和基底反应,还能减少杂质残留。比如有些经过修饰的烷基配体,能做出不会自燃的前驱体,替代原来容易着火的三甲基铝(TMA)这类烷基金属材料,既提高了操作安全性,又不影响镀膜效果。
共反应物是前驱体的好搭档,主要帮三件事:去掉前驱体里多余的配体、让薄膜形成稳定的晶体结构、让基底表面恢复反应能力,方便下一轮循环。常见的热共反应物有纯水、臭氧、氨气,比如用纯水和三甲基铝搭配,就能沉积出氧化铝薄膜,用氨气和金属卤化物搭配,能做出氮化钛薄膜;还有等离子体增强型共反应物,比如氧气、氢气等离子体,通过电场激发让气体变成高活性的自由基,能让ALD在室温下就能进行——这对高分子、生物材料这类怕热的基底来说太重要了,还能提高薄膜纯度,甚至能沉积出纯金属和难熔化合物。不过要精准控制等离子体参数,不然高能粒子可能会像小锤子一样,砸坏脆弱的基底或薄膜。
反应器就像是ALD的工作间,不同的应用场景需要不同设计的工作间。实验室里常用的横流反应器结构简单,适合做基础研究和小批量样品;工厂里用的喷淋头反应器,能让前驱体和共反应物像淋浴一样均匀覆盖晶圆,保证镀膜均匀性,是半导体量产的主力设备;批次反应器更厉害,一次能处理多达500个基底,就像工业烤箱一样,大大提高生产效率,特别适合太阳能电池和半导体的大规模生产。
还有些针对特殊需求设计的专用反应器,比如空间ALD系统,分片对片和卷对卷两种:片对片适合刚性的晶圆、玻璃基板,卷对卷则专门处理柔性的塑料薄膜,就像打印机卷纸一样连续镀膜。它们的核心创新是把前驱体和共反应物放在不同的空间区域,基底移动着依次经过这些区域,中间不用停下来吹扫,把单次循环时间缩短到毫秒级,生产效率大幅提升。流化床和转鼓反应器则专门给颗粒镀膜,比如电池电极颗粒、催化剂颗粒,能让每个微米级的小颗粒表面都均匀裹上薄膜,就像给每颗沙子都刷上一层漆。
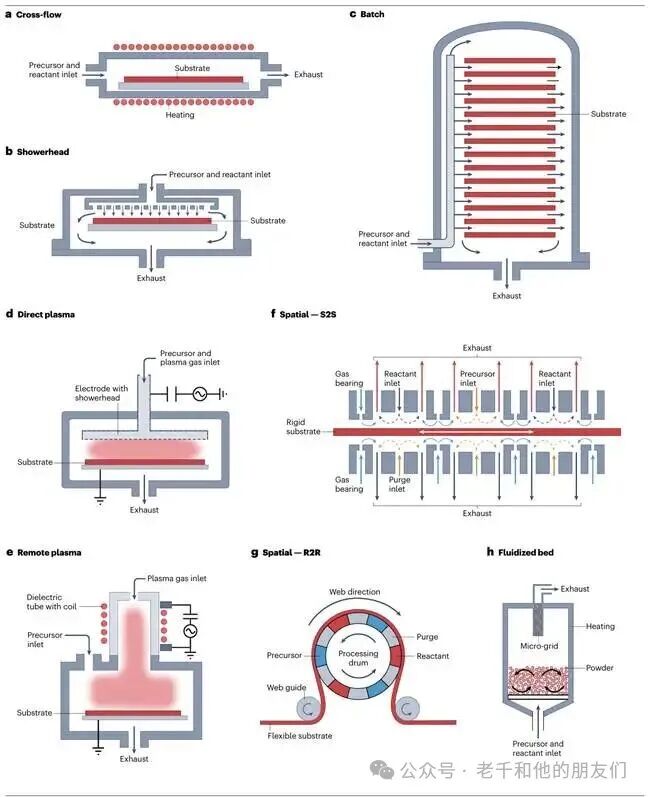
图 3 常见原子层沉积(ALD)反应器
a-e. 常规反应器:横流反应器(a 图)、喷淋头系统(b 图)、批次系统(c 图)、直接等离子体反应器(d 图)及远程等离子体反应器(e 图,含电感耦合等离子体(ICP)源)。除批次式原子层沉积(ALD)系统可处理 10 至 500 余片晶圆或基底外,其余系统通常为单晶圆系统;科研应用中,单晶圆系统常装载基底样品片。 f-h. 专用反应器(适配特定应用场景):刚性基底用空间 ALD 系统(常称片对片(S2S)ALD,f 图)、柔性基底用空间 ALD 系统(常称卷对卷(R2R)ALD,g 图)及粉体 ALD 用流化床系统(h 图)。
工艺参数是ALD的调节旋钮,主要调三个关键项:温度窗口、前驱体剂量、吹扫时间。
温度窗口是最核心的参数,只有在这个温度范围内,反应才能保持自限制特性——温度太低,前驱体可能会凝结在基底上,反应也不够充分;温度太高,前驱体又会分解,破坏镀膜的均匀性。比如沉积氧化铪薄膜,温度窗口大概在200-350℃,超出这个范围,薄膜质量就会明显下降。
前驱体剂量和吹扫时间需要通过实验确定,剂量不足,基底表面的反应位点就占不满,薄膜会变薄;吹扫时间太短,多余的前驱体和共反应物没吹干净,就会在气体中直接反应,形成寄生CVD反应,让薄膜变得不均匀。工程师们通常会通过饱和曲线来找到最佳参数——这条曲线能清晰看出,随着前驱体或共反应物用量增加,薄膜生长量会先上升,等表面反应位点全占满后,生长量就稳定下来,这时候的参数就是最合适的。

图 4 原子层沉积(ALD)典型结果
a 300℃下,以 CpZr (NMe₂)₃和 Zr (NEtMe)₄为前驱体、O₃为共反应物时,ZrO₂薄膜的每循环生长量(GPC)随金属前驱体脉冲时间的变化曲线。均配体前驱体(实心圆点)工艺无饱和特性,一个胺基配体被环戊二烯基(Cp)取代的杂配体前驱体(空心圆点)工艺呈现饱和特性。
b. 采用 CpZr (NMe₂)₃/O₃工艺在深宽比 60:1 沟槽中生长 ZrO₂薄膜的横截面SEM图像,展示沟槽顶部、中部和底部的覆盖情况
c. 以卢瑟福背散射光谱法(RBS)测量硅基不同初始表面上,HfO₂生长过程中 Hf 的覆盖度随 HfCl₄-H₂O ALD 循环次数的变化关系。d-f. GPC 的温度依赖性。
d 图为 Hf (NEtMe) 与 H₂O 组合制备 HfO₂薄膜的情况;
e 图为 Ir (acac)₃与 O₂组合制备 Ir 薄膜的情况;
f 图为 GeCl₂・(C₄H₈O₂) 与 (Et₃Si)₂Te 组合制备 GeTe 薄膜的情况。d 图和 e 图右侧纵轴分别为薄膜的折射率和电阻率。
g. GeTe 沉积于 3D 相变存储单元的横截面TEM图像:薄膜均匀覆盖沟槽所有表面,并完全填充沟槽底部 31×84 nm² 的通道(箭头所示)。
h-i. 超循环工艺示例:h 图为锗锑碲(GST,Ge₂Sb₂Te₅)薄膜成分随超循环中 GeTe 与 Sb₂Te₃循环比例的变化关系;i 图为铝掺杂氧化锌(ZnO:Al)薄膜中 Al 掺杂含量随超循环中 ZnO 与 Al₂O₃循环比例的变化关系。j. 100℃下,Al₂O₃表面经 50、100、150 和 200 次 Pd ABC 型工艺处理后的HAADF-STEM图像。该工艺包括 Pd (hfac) 暴露、H₂等离子体暴露和 O₂等离子体暴露步骤;基底为覆盖 3 nm ALD-Al₂O₃的氮化硅(Si₃N₄)TEM 窗口。
注:at.% 为原子百分比;RTO 为快速热氧化;RTNO 为一氧化氮氛围快速热氧化。
ALD如何改变各个行业?
ALD从实验室走进工厂,核心是它能解决很多行业的痛点问题,现在已经成为半导体、可再生能源、显示、电池等领域不可或缺的关键技术。
在半导体行业,随着芯片越做越小(已经到3纳米以下节点),ALD成了名副其实的技术核心。比如芯片里的CMOS晶体管栅极和DRAM电容器,原来用的二氧化硅(SiO₂)薄膜,当厚度降到1纳米以下时,漏电流会变得很大,导致芯片发热、耗电快;而用ALD沉积的氧化铪(HfO₂)、氧化锆(ZrO₂)等高k介质材料替代后,既能保持足够的电容,又能把漏电流降到原来的几十分之一,让芯片能继续微型化。
对于3D NAND存储器——我们手机里的大容量闪存很多都是这种技术制造的,ALD能给超过200层的存储单元镀膜,这些单元堆叠起来的深宽比超过50:1,就像一堆密密麻麻的微小深井,只有ALD能保证每一口井的内壁都均匀覆盖薄膜,让存储密度大幅提升。此外,在FinFET晶体管的图案化、全环绕栅极(GAA)晶体管的制造中,ALD能精准控制栅极堆叠的厚度,误差不超过0.1纳米,是芯片性能提升的关键。

图 5 原子层沉积(ALD)在半导体行业的应用
A 堆叠式 1T-1C 动态随机存取存储器(DRAM)电容器结构示意图,及两个 DRAM 电容器水平横截面的TEM图像:电容器电极间的介质堆叠层由 ZrO₂和 Al₂O₃组成,左侧为三星 58 nm 节点(2009 年)产品,右侧为美光 20 nm 节点(2016 年)产品,电容器深宽比分别为 10 和 24。
B. 2007 年英特尔在其 45 nm 节点产品中,采用高 k 氧化物替代二氧化硅(SiO₂)作为金属 – 氧化物 – 半导体场效应晶体管的栅介质。该场效应晶体管包含源极(S)、漏极(D)和栅极; TEM 图像放大展示了介质堆叠层,由约 1.1 nm 的化学二氧化硅(SiO₂)和约 1-1.3 nm 的原子层沉积(ALD)HfO₂组成,堆叠层表面覆盖氮化钛(TiN)。
C. 先进图案化示例:Ca 图为包含等离子体增强 ALD 沉积间隔层的自对准四重图案化(SAQP)工艺示意图; Cb 图为在光刻胶线上沉积二氧化硅(SiO₂)间隔层的情况; Cc 图为英特尔 22 nm 节点(鳍间距 60 nm,2012 年)鳍式场效应晶体管(FinFET)的 TEM 图像(采用自对准双重图案化(SADP)工艺); Cd 图为台积电 10 nm 节点(鳍间距 33 nm,2016 年)FinFET 的 TEM 图像(采用 SAQP 工艺)。
D. 含电荷俘获闪存结构的三维(3D)NAND(非与)逻辑栅串示意图,该结构涉及 ALD 工艺步骤;对应SEM(左图)和 TEM(右图)图像展示了 SK 海力士的 3D NAND 产品:左图为 72 层器件的整体视图(高度 4.7 μm,深宽比约 50),含 72 条活性字线(WL)和 82 个堆叠栅极(2015 年);右图为 36 层器件的沟道与字线水平横截面视图(高度 2.6 μm,深宽比 25),含 36 条活性字线和 43 个堆叠栅极(2018 年)。注:TEM 图像由 TechInsights 提供。
在可再生能源领域,ALD让太阳能电池的性能实现了质的飞跃。比如现在主流的PERC太阳能电池,在硅片背面用ALD沉积一层5-20纳米厚的氧化铝薄膜做表面钝化,能减少电池内部光生载流子的复合——简单说就是减少电流的浪费,让转换效率从原来的不到20%提升到22%以上,现在这已经是太阳能电池工厂的标准工艺。对于钙钛矿太阳能电池和叠层太阳能电池,ALD能在低于150℃的低温下,做出致密的电荷传输层和封装薄膜,既不会破坏脆弱的钙钛矿材料,又能阻挡水汽和氧气,让电池的使用寿命从几百小时延长到几千小时。
在显示行业,ALD的优势在于超强阻隔性和超高精准度。柔性OLED屏幕最大的敌人是水汽和氧气——哪怕是微量的水汽进入,也会让屏幕发光层失效,而用ALD沉积的二氧化硅、氧化铝薄膜做封装层,能把水汽渗透率降到10⁻⁶克/平方米/天以下,相当于给屏幕穿了一件防水防氧的纳米雨衣,让柔性OLED能用于汽车屏幕、智能手表等要求高可靠性的产品。在薄膜晶体管(TFT)中,ALD生长的铟镓锌氧化物(InGaZnO)半导体,能在超大尺寸基底(最大可达2200×2500毫米,相当于一张大办公桌大小)上保持均匀性能,每个晶体管的开关速度都一致,支撑高分辨率、高刷新率显示面板的制造。
在电池技术领域,ALD解决了电极容易损坏的老大难问题。锂电池的正极材料(如钴酸锂LiCoO₂)在充放电过程中,会和电解液发生副反应,导致结构坍塌,容量越来越小;负极材料(如硅材料)体积变化大,容易粉化脱落。而给这些电极颗粒表面,用ALD镀一层1-5纳米厚的氧化铝或二氧化钛薄膜,就像给每个颗粒穿了一件纳米防护衣,能减少电极和电解液的无效反应,避免结构坍塌,还能阻止锂枝晶生长,让电池循环寿命延长30%以上,安全性也大幅提升。
对于固态电池,ALD能给三维电极镀上均匀的固态电解质(如LiPON),让离子传输更顺畅,解决传统固态电池界面接触不良的问题。现在,专门用于颗粒镀膜的流化床ALD设备,每天能处理超过30吨的电池颗粒,已经能满足工厂大规模生产的需求。

图 6 原子层沉积(ALD)在太阳能电池、显示、电池及其他行业的应用
a. 太阳能电池组件图像,及对应的钝化发射极和背面接触(PERC)太阳能电池示意图与TEM图像。 PERC 电池中,晶体硅(c-Si)背面通过 Al₂O₃/SiN₃堆叠层实现钝化(见 TEM 图像); Al₂O₃薄膜厚度通常为 2-20 nm,常通过原子层沉积(ALD)制备;硅(Si)与 Al₂O₃之间会形成界面氧化物;图中还展示了 Al₂O₃/SiO₂界面的负电荷,该电荷会在 Si 中及 Si/SiO₂界面形成空间电荷区(白色虚线标注)。
b. 汽车应用中的柔性有机发光二极管(OLED)显示器示例及其结构示意图。薄膜封装(TFE)层已从三层堆叠扩展为四层堆叠,除等离子体增强化学气相沉积(PECVD)制备的氮化硅(SiN)层和印刷有机层外,新增等离子体增强 ALD(PEALD)制备的 SiO₂层。
c. 锂离子电池及其结构示意图与 TEM 图像:正极颗粒表面通过 ALD 制备的超薄保护层实现稳定化;图中为包覆超薄 Al₂O₃薄膜的钴酸锂(LiCoO₂)颗粒。
d. 其他应用:银首饰的抗变色涂层、X 射线显微镜用菲涅尔波带片透镜及微通道板探测器。
注:BSF 为背表面场; TFT 为薄膜晶体管。
除了这些核心领域,ALD还有很多实用场景:在催化领域,用ALD做的纳米颗粒催化剂,比如铂、钯颗粒,尺寸均匀(误差小于1纳米)、分散性好,能大幅提高反应活性和稳定性,比如用于汽车尾气净化的催化剂,使用寿命能延长一倍;在光学领域,ALD能做出高精度的光学涂层,比如用于X射线显微镜的铱涂层,能提高成像分辨率;在微机电系统(MEMS)中,ALD能镀上抗粘滑、防腐蚀的保护层,比如微型传感器的齿轮表面,镀上一层ALD薄膜后,不会因为摩擦而失效;甚至在文物保护中,ALD能给银器、博物馆里的金属文物镀上一层超薄保护膜,防止氧化变色,还不影响文物的外观和质感。
可重复性与标准化:ALD能大规模应用的关键
ALD之所以能从实验室走进工厂,成为工业生产的常客,一个重要原因是它的可重复性。这种可靠性源于它的自限制反应特性:只要参数设置正确,每次循环的厚度增量都是固定的,不管是今天做还是明天做,这台设备做还是那台设备做,结果都能保持一致。
衡量可重复性有三个关键指标:一是同一基底上的均匀性,工业生产中能做到厚度偏差不超过1.5%,比如在12英寸晶圆上,最厚的地方和最薄的地方差别不到0.1纳米;二是不同基底之间的一致性,比如沉积氧化铪薄膜时,连续生产100片晶圆,每片的厚度偏差能控制在0.5%以内,不会出现某几片质量不合格的情况;三是不同设备之间的兼容性,同款反应器按照相同参数设置,做出来的薄膜效果差别不超过1%,方便工厂批量投产,不用每台设备都重新调试很久。
为了保证这种可重复性,需要有标准化的数据记录和报告。不管是实验室研究还是工厂生产,都要详细记录关键数据:不同温度下的每循环生长量(GPC)、前驱体和共反应物的用量与吹扫时间、沉积温度和压力、薄膜的均匀性和保形性测试结果等。有了这些标准数据,不同研究团队、不同工厂之间就能互相参考,方便技术交流和工艺推广,比如一家工厂开发的ALD镀膜工艺,能快速转移到另一家工厂的设备上,不用从零开始研发。
现存局限与优化方向
虽然ALD很好用,但它也有自己的短板,这些问题也正在被科研人员和工程师们不断解决,让ALD变得更高效、更实用。
最大的问题是生产效率低。因为ALD是循环式沉积,还要经过两次吹扫,它的生长速率通常在0.1到1纳米每分钟,比PVD、CVD慢10倍甚至几十倍。比如沉积一层10纳米厚的薄膜,ALD可能需要100多个循环,耗时几分钟,而CVD可能几秒钟就完成。这在大规模生产中会导致成本上升,比如太阳能电池工厂,需要快速处理大量硅片,效率太低就不划算。
现在的解决办法有三种:用空间ALD省去吹扫步骤,让基底连续移动镀膜,把生产效率提高10倍以上;用批次反应器一次处理更多基底,比如一次处理500片晶圆,分摊成本;优化循环参数,把单次循环时间缩短到500毫秒以内,让每分钟能完成100多个循环。
另一个问题是,有些情况下薄膜的均匀性和保形性不够理想。比如反应产生的副产品(如HCl、醇类)可能会重新吸附在基底上,挡住反应位点,导致局部区域镀膜变薄;等离子体中的活性粒子在复杂结构表面可能会互相结合,失去反应活性,导致深宽比特别大的结构底部镀膜不均匀。
针对这些问题,工程师会优化反应器设计,比如用喷淋头改善气流分布,让前驱体能均匀到达基底各个部位;调整工艺参数,比如增加前驱体浓度、延长暴露时间,让反应物能深入到结构底部;对于超高深宽比结构,采用静态暴露替代动态暴露——也就是让前驱体在反应腔里停留一段时间,而不是持续流动,让反应物有足够时间扩散到每个角落。
还有就是薄膜可能含有杂质。如果沉积温度太低,前驱体里的部分配体可能脱除不干净,会在薄膜中留下碳、卤素等杂质;温度太高,前驱体又可能分解,同样会引入杂质。这些杂质会影响薄膜的性能,比如让绝缘薄膜的漏电增加,让导电薄膜的电阻变大。解决办法是用等离子体增强型共反应物,比如用臭氧替代纯水,能更彻底地氧化配体,减少碳残留;或者开发更容易脱除配体的前驱体,比如杂配体配合物,让配体在温和条件下就能顺利脱除。
另外,有些材料的前驱体很少,甚至没有合适的源头材料。比如铝、镁这类电正性金属,还有二硫化钼、黑磷这类二维材料,很难找到同时满足挥发性、反应性和热稳定性的前驱体,导致它们的ALD沉积工艺很难实现。现在科研人员正在设计新型前驱体,比如给电正性金属搭配特殊的还原剂,或者开发气相稳定的二维材料前驱体,不断扩大ALD能沉积的材料范围。
未来ALD会变成什么样?
ALD的未来,不只是简单的薄膜沉积,还会发展成一套原子尺度工程工具包,能做更多更复杂的事情,从刷原子变成原子级雕刻、组装,给更多领域带来创新。
在材料方面,科研人员会重点开发二维材料(如二硫化钼、二硫化钨)的ALD沉积技术,实现晶圆级的均匀生长——现在的二维材料大多是小面积的,用ALD能做出大面积、高质量的二维材料薄膜,适配半导体工艺,用来制造更薄、更快的晶体管;对于铝、镁这类难沉积的电正性金属,会开发新型还原剂和前驱体,让它们也能通过ALD沉积,用于制造轻质、高强度的合金材料;还会发展分子层沉积(MLD)技术,沉积有机材料或有机–无机杂化材料,做出具有特殊性能的涂层——比如更柔韧、能自我修复的薄膜,可用于柔性电子;或者生物相容性好的薄膜,能给植入人体的医疗器械镀膜,减少身体的排斥反应。
在技术方面,会出现更多先进的加工方式。比如区域选择性沉积(ASD),能让薄膜只在基底的特定区域生长,不用光刻就能做出图案——就像在纸上只在指定区域打印,省去了复杂的刻蚀步骤,突破现有芯片制造的尺寸限制,让芯片集成度更高;原子层刻蚀(ALE)会和ALD配合,形成沉积–刻蚀的循环,实现原子尺度的材料去除——比如沉积多了一层,就用ALE精确刻掉,让器件制造的精度达到单个原子级别;气相渗透(VPI)技术会把ALD前驱体和聚合物结合,给块状材料赋予新功能,比如让普通塑料变得耐高温、耐腐蚀,或者让橡胶变得导电,拓展复合材料的应用场景。
在应用方面,ALD会在解决全球难题中发挥更大作用。在能源领域,用ALD设计的三维电极和固态电解质,会让电池能量密度提高一倍以上,电动汽车充电一次能跑1000公里;用ALD做的催化剂,能让制氢效率大幅提升,降低氢能的成本;在环保领域,ALD制造的高效催化剂,能把工业废气中的二氧化碳转化为甲醇等有用的化学物质,减少温室气体排放;在量子技术领域,ALD的精准控制能力,会帮助制造量子点、超导薄膜等关键材料,让量子计算机、量子通信更快走向实用化。
参考资料Atomic layer deposition https://doi.org/10.1038/s43586-025-00435-6


