作者:孙千 本文转载自公众号:老千和他的朋友们。原文地址:https://mp.weixin.qq.com/s/5V-za4_IiBuSf8K768QXdA
制备扫描电镜(SEM)或透射电子显镜(TEM)样品时,聚焦离子束(FIB)横截面切割是关键步骤。为避免切割中出现条纹伪影,同时防止离子注入损伤样品最外层约 50 纳米区域,行业常用 FIB 辅助化学气相沉积(CVD)技术沉积铂(Pt)、钨(W)等金属保护层。
借助双束(FIB/SEM)仪器,电子束辅助沉积(EBAD)层可替代离子束辅助沉积(IBAD)层减少离子损伤。但EBAD耗时约为IBAD的20倍,完整保护层极少采用厚度超200纳米的 EBAD层,多为 “50-200纳米 EBAD层+ IBAD层” 的复合结构。
铂基保护层的气体注入系统(GIS)前驱体为有机金属材料,EBAD铂与IBAD 铂均非纯金属,是铂与碳组成的纳米晶非均相混合物,沉积层可能含过量氧,IBAD铂涂层中还会检测到镓元素。且铂原子序数较高,在Z衬度高角环形暗场(HAADF)扫描透射电镜(STEM)成像中易主导衬度。
近年来,低能镓离子(Ga⁺)FIB 技术结合双束仪器,已能制备出达到像差校正(S)TEM 亚埃级信息极限的样品。
Brandon Van Leer等人的研究对比碳(C)沉积层与铂沉积层的性能,验证碳层作为 FIB 制备优质(S)TEM 样品保护层的效果。

实验以硅(Si)为基底,分别沉积 EBAD/IBAD 碳层和 EBAD/IBAD 铂层。样品经 Ga⁺离子 FIB 铣削处理:先以30keV能量、88.5 度入射角铣削,再以5keV能量、85 度入射角加工,最后以 2 keV能量、82 度入射角抛光。通过 30keV能量的明场(BF)、暗场(DF)STEM 成像观察晶粒形态,用 TRIM 模拟计算分析溅射速率差异。
STEM 成像显示:EBAD 铂晶粒尺寸1-3 纳米,IBAD铂10-20 纳米,IBAD 铂晶粒大于EBAD 铂,与此前研究结论一致;碳层无论 EBAD 还是 IBAD 模式沉积,均为亚纳米级晶粒,仅IBAD 碳晶粒略大于 EBAD 碳,整体尺寸更小、分布更均匀。
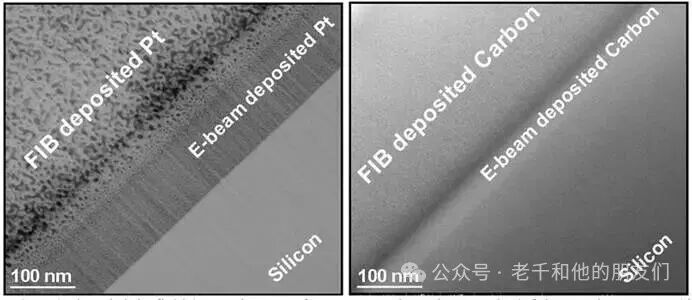
图 1. FIB 制备样品的 30 keV明场 STEM 图像。左图为硅上沉积铂,右图为硅上沉积碳。
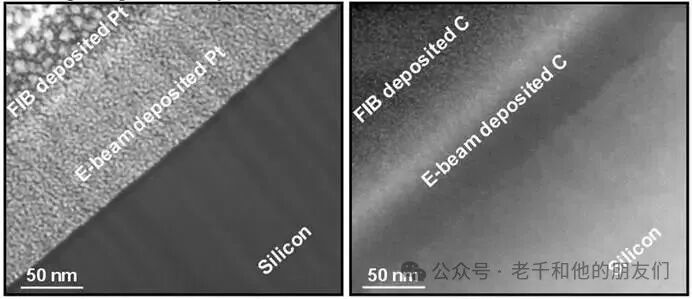
图 2. FIB 制备样品的 30keV暗场 STEM 图像。左图为硅上沉积铂,右图为硅上沉积碳。
TRIM 计算结果表明:30keV条件下,碳的溅射速率比铂快约 24%;5keV时,两者溅射产额差异超 30%。低能铣削阶段,铂溅射速率慢,易产生边缘效应,表现为 STEM 图像中铂层保护的硅样品出现明显条纹伪影;碳层溅射速率适配低能铣削,且晶粒小而均匀,碳层保护的硅样品未观测到条纹伪影。
研究结论为:碳沉积层作为 FIB 制备(S)TEM 样品的保护层,性能优于传统铂沉积层。碳层具备亚纳米级晶粒尺寸、均匀的晶粒分布、适配低能铣削的溅射速率,且低原子序数特性避免成像时衬度被主导,能更好支撑高分辨率(S)TEM 分析,在材料科学、微电子工程等领域具有应用价值。
参考资料Protective Carbon Deposition for Superior FIB Prepared (S)TEM Specimens


